Površinska analiza
- Tandemska masna spektrometrija sekundarnih ionov z analizatorjem na čas preleta (ToF-SIMS MS/MS),
- rentgenska fotoelektronska spektroskopija (XPS),
- mikroskopija na atomsko silo (AFM),
- 3D-profilometrija,
- optični sistem za merjenje omočitvenega kota,
- ATR-FTIR-analiza,
- Spektroskopija LIBS.
Oprema
Instrument za XPS-analizo Kratos Supra+
Rentgenska fotoelektronska spektroskopija (XPS) je tehnika za površinsko analizo, ki omogoča določanje elementne sestave in okolja elementa – njegovo oksidacijsko stanje in kemijske vezi.
Kratos Supra+ omogoča avtomatske kotno ločljive meritve, segrevanje in hlajenje vzorca ter globinsko profiliranje organskih snovi s tehnologijo GCIB (angl. gas cluster ion beam) in globinkso profiliranje anorganskih snovi z monoatomnim Ar+.

Kratos Supra+
ToF-SIMS (MS/MS) IONTOF M6
Masna spektrometrija sekundarnih ionov z analizatorjem na čas preleta (angl. time-of-flight secondary ion mass spectrometry, ToF-SIMS) je tehnika površinske analize, ki se uporablja za merjenje masnih spektrov na površini trdnih snovi. Spektrometer omogoča visokoločljivo analizo elementne in molekulske sestave površin. Omogoča visoko masno ločljivost, visoko prostorsko ločljivost in globinsko profiliranje z dvojnim izvorom ionskih žarkov, tako za prevodne kot za izolacijske materiale.
Uporaba različnih ionskih izvorov omogoča analizo anorganskih in organskih materialov (slednje zlasti v kombinaciji z GCIB), pri čemer lahko izmerimo spektre visoke masne ločljivosti tudi za lažje elemente, kot so vodik, dušik in kisik. Omogoča tudi pridobivanje slike površine (angl. imaging) z visoko prostorsko ločljivostjo (<50 nm).
Naprava omogoča tandemsko (MS/MS) analizo z analizatorjema ToF/ToF in ohlajanje in segrevanje vzorca ob sočasni ToF-SIMS analizi. Opremljena je z EDR analizatorjem in različnimi izvori ionskih žarkov (Bi-LMIS, Cs/O2+ in GCIB).
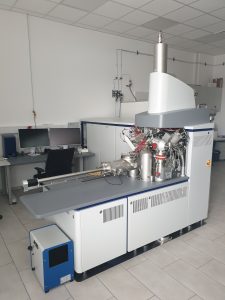

AFM instrument, model MFP 3D Origin Plus (Asylum/Oxford Instruments)
Mikroskop na atomsko silo (angl. atomic force microscope, AFM) omogoča preučevanje topografije v atomski ločljivosti in študij interakcij med AFM-konico in atomi vzorca. Uporaben je za preučevanje tako prevodnih kot tudi neprevodnih materialov.
Oprema, ki smo jo namestili v naš laboratorij, ima možnost sklopitve s potenciostatom/galvanostatom, kar omogoča izvajanje elektrokemijskih meritev ob spremljanju topografskih in morfoloških lastnosti vzorca na atomski skali.


Profilometer DektakXT (Bruker)
Kontaktni profilometer je instrument, ki omogoča določitev profila vzorca tako, da z diamantno konico drsi po površini in zapisuje odmik od referenčne ravnine vzorca. Tako pridobimo podatke o hrapavosti površine, 3D-profilu površine in tudi debelini površinske plasti.
Napravo uporabljamo za preiskovanje različnih vrst trdnih materialov površine do 10 cm v x-smeri in do 10 cm v y-smeri. Slednje dopolnjuje meritve mikroskopije na atomsko silo (AFM), kjer smo omejeni na 120 mikrometrov v x-smeri in 120 mikronov v y-smeri. V primerjavi z AFM, profilometer omogoča določanje topografije vzorcev z mnogo večjo višinsko razliko, vendar je njegova prostorska ločljivost (v primerjavi z instrumentom AFM) manjša.
Profilometer DektakXT proizvajalca Bruker je opremljen s konicami premera 2 µm, 5 µm in 12 µm.
Optični sistem za merjenje omočitvenega kota, OCA 25 (DataPhysics Instruments GmbH)
Optični sistem za merjenje omočitvenega kota OCA 25 je merilna naprava, ki se uporablja za merjenje kontaktnega kota in analizo oblike kapljic. Vzorčna miza je nastavljiva v vseh treh smereh v prostoru z natančno mehaniko, kar zagotavlja hitro ročno postavitev vzorca. Analiza tudi najhitrejših procesov je omogočena s snemanjem do 3250 slik na sekundo, pri čemer se uporablja objektiv s 6,5 x povečavo in visoko zmogljiva kamera. Za doziranje tekočin se lahko uporablja enojni ali dvojni sistem neposrednega doziranja, kot tudi elektronski večkratni sistem. Uporablja se za merjenje kontaktnih kotov na absorpcijskih površinah, kot so tkiva ali praški.
ATR-FTIR, IRAffinity-1 (Shimadzu)
Tehnika ATR-FTIR (angl. attenuated total reflectance Fourier transform infrared spectroscopy) omogoča merjenje infrardečega spektra vzorcev brez dodatne predpriprave. Vmesnik za tehniko ATR meri spremembe, ki se pojavijo v notranjem odbojnem infrardečem žarku, ko žarek pride v tesen stik z vzorcem.
Da bi bila tehnika uspešna, mora biti lomni količnik ATR kristala večji od lomnega količnika vzorca (vzorec mora biti optično redkejši od ATR-kristala.)
ATR-FTIR je zelo uporabna tehnika za analizo plasti na površini trdnih vzorcev, ki so debelejše v primerjavi s tistimi, ki jih merimo z XPS in ToF-SIMS tehnikama, omogoča pa tudi zelo preprosto analizo tekočih vzorcev. ATR-FTIR ima široko uporabo v industriji, in sicer za analizo prehrambnih izdelkov, za analizo biodizla in drugih avtomobilskih tekočin, farmacevtskih izdelkov itd.
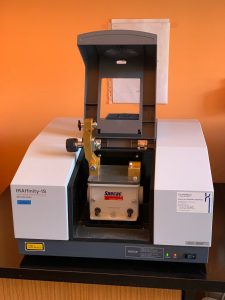
Spektroskopija LIBS – angl. laser-induced breakdown spectroscopy (LIBS; Vulcan EXPERT+, HITACHI)
Spektroskopija LIBS je analizna tehnika, ki se uporablja za hitro elementno analizo materialov, pri čemer pogosto ni potrebna predpriprava vzorca.
Temelji na generiranju visokotemperaturne plazme, ki nastane ob obstreljevanju vzorca s fokusiranim kratkim laserskim pulzom. To povzroči ablacijo materiala in prehod elementov v vzbujeno stanje. Ob relaksaciji iz vzbujenega v osnovno stanje elementi emitirajo svetlobo s karakterističnimi valovnimi dolžinami, ki jih zazna detektor.
Tipična meja zaznavnosti tehnike LIBS za elemente težkih kovin je v območju delcev na milijon (angl. parts per million, ppm). Tehnika ima širok spekter uporabe kot je na primer analiza zlitin, polprevodnikov, stekel, izolatorjev, plastike, tankih premazov barv, elektronskih materialov itd.



